Precision BGA Reball
Solder ball exchange with automated technology for high-reliability solutions
Spirit’s proprietary automated BGA ball removal process
Spirit’s automated technology safeguards your BGA from ball removal to final inspection.
BGA Reballing Services
- Lead-free to tin-lead (SAC305 → 63/37)
- Compliant with industry lead (Pb) composition requirements
- Capable of 45,000 ball placements per hour
- Supports high-ball-count FPGAs and ultra-small solder ball sizes
- Automated for high-volume production with precision and repeatability
Automated Optical Inspection (AOI) Every Step of the Way
- The same automated technology used in the final ball scan inspects balls and arrays during printing, ball placement, and before reflow
- Laser automation and true-color 12 megapixel camera inspect balls and arrays.
- Precision AOI can even inspect for warpage of the BGA substrate.
- AOI identifies issues during pick-and-place and will automatically sort and replace missing or damaged balls before the array leaves the assembly line.
- Programmed auto-sort will identify damaged solder balls and reject them before they are placed.
- Avoid rework and line delays.
Capabilities & Capacity

Robotic Ball Removal Process
Proper BGA reballing preserves the integrity of the underlying pad, whether gold, copper, or nickel, ensuring a reliable interconnect that performs consistently throughout the product’s lifecycle.
By maintaining pad quality during the reballing process, potential latency and signal integrity issues are eliminated before they can surface later in service.
This proactive approach protects long-term performance and reduces the risk of field failures, making precision reballing a critical investment in product reliability.

Coplanarity Inspection
- Automated optical inspection checks all BGAs for:
i. Diameter
ii. Spacing
iii. Pitch
iv. Missing balls
v. Damage solder ball
vi. Location - Rejected BGAs are auto-sorted to remove them from the line and identify the issue down to the individual ball.

XRF and SAM Inspection
- XRF analysis confirms solder ball composition, ensuring leaded solutions meet all applicable requirements
- SAM inspection provides non-destructive, sub-surface imaging of BGA connections — identifying voids, delamination, and material anomalies without compromising the component
- Together, XRF and SAM deliver a complete quality verification solution for reballed BGAs
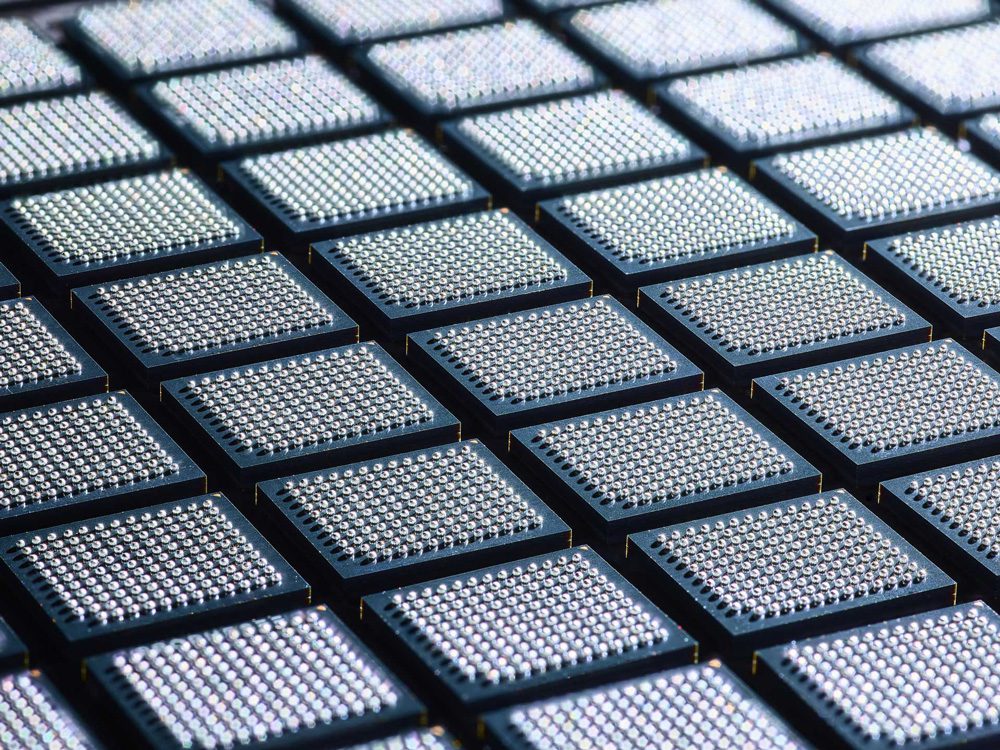
Dedicated Capacity
Domestic BGA reballing capacity is limited, and as supply chain pressures and demand for leaded reball services continue to grow, few providers can meet the need. Spirit has the infrastructure and workforce flexibility to scale, including dedicated third-shift capacity for customers requiring committed production availability.
Industry Standards:
- J-STD-001
- J-STD-004
- J-STD-006
- J-STD-033
- IPC-7711/7721
- GEIA-STD-0006
- ANSI/ESD S20.20 and JESD625 for ESD Control
- AS9100 Quality Management for Process Controls
Discuss Your Project with
Spirit's Technical Team
Spirit can provide complete process development from prototyping through launch. Contact our seasoned team of engineers to discuss your next project.
